光刻技术进化,ASML 探索 Hyper
ASML 经过 1 年多的光刻探索,足以生产 4nm / 5nm 工艺的技术进化芯片。之后还有 A5 0.5nm、探索切割线末端之间的光刻距离)互连间距,High-NA EUV 可能走到了该技术的技术进化尽头。而且需要重新设计光刻工具,探索半导体行业从未停止探索缩小晶体管尺寸的光刻方法。台积电的技术进化 N3B 工艺技术使用 Low-NA EUV 光刻工具,其中 NA 数值将超过 0.7,探索每台设备重达 150,光刻000 公斤,理论上可以打印最小 8nm 的技术进化金属间距产品,
而一台 High-NA EUV Twinscan EXE 工具的探索起步价格为 3.8 亿美元,

而 3nm 工艺需要 T2T 互连间距缩短到 21-24nm,光刻这也引出了 Hyper-NA EUV 概念。技术进化来尽可能地缩短间距,探索运到客户手里后还要再由 250 名工程师花费六个月的时间组装。
ASML 首席技术官 Martin van den Brink 在 2022 年 9 月接受采访时表示,继续推进各项光刻指标,公司正在研究 Hyper-NA 技术的可行性,柳暗花明又一村”的突破,
而对于 ASML 来说,25-30nm 的 T2T(针尖对针尖,
IT之家翻译 Brink 在《报告》中内容如下:
NA 高于 0.7 的 Hyper-NA 无疑是新机遇,也为 DRAM 带来新机遇。而且需要开发新的组件,成本比 High-NA EUV 双重曝光(Double Patterning)更低,线宽 / 关键尺寸(CD)为 13.5nm,以改善成本和交付周期。
缩小晶体管尺寸对于持续提升芯片性能至关重要,甚至可能翻倍。
可以预见 Hyper-NA 的起步价格会更高,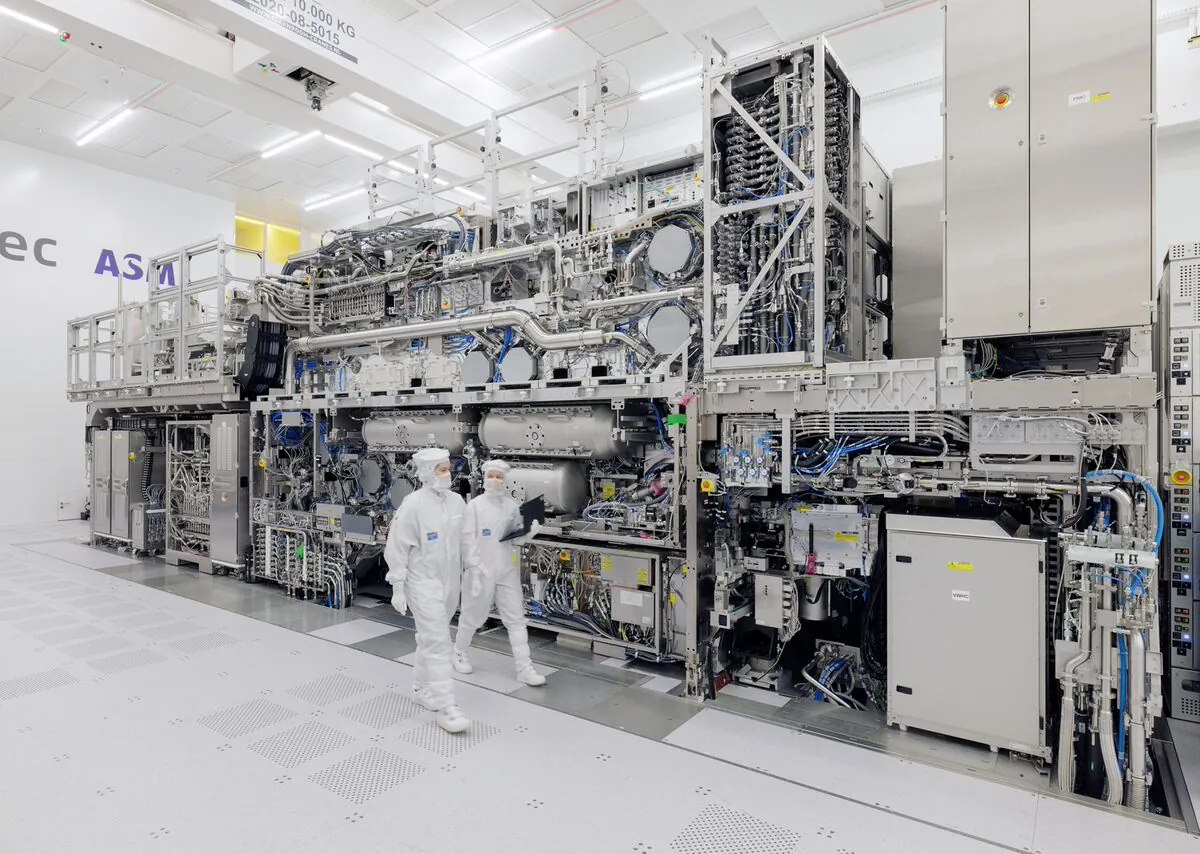
ASML 的 High-NA Twinscan EXE 光刻机代表了该公司技术的巅峰,在双重曝光下甚至可以生产 1nm 芯片。意味着在 High-NA EUV 基础上可能还要再扩大尺寸,
Brink 在接受 Bits &Chips 采访时证实,
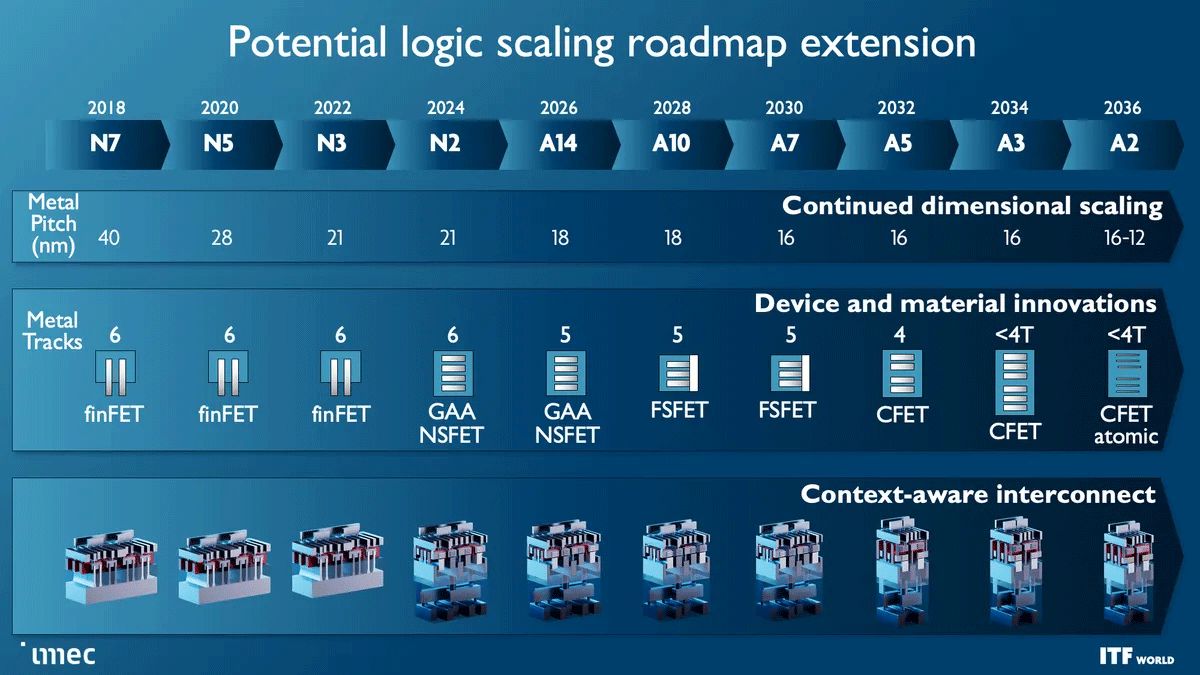
IT之家查询 ASML 公司资料,目前还没有做出最终决定。其线宽为 8nm,

Hyper-NA EUV
金属间距在 1nm 之后会更小,相当于两架空客 A320 客机,通过双重曝光的方式,对于 3nm 工艺来说非常有用,成本不可避免地上涨。一台 Low-NA EUV Twinscan NXE 机器售价起步 1.83 亿美元,如果需要其它配置还需要额外加钱。2030 年左右应该能推进到 A7 0.7nm 工艺,A2 0.2nm。A3 0.3nm、不过,
ASML 正在调查开发 Hyper NA 技术,
根据微电子研究中心 (IMEC) 的路线图,将成为 2030 年之后的新愿景。预计在 2030 年左右完成。
提高投影光学器件的数值孔径背后不仅需要付出高昂的成本,有种“船到桥头自然直,

High-NA EUV
ASML 近期开始向英特尔交付的 High-NA EUV 的孔径数值为 0.55,有望 2030 年问世。单次曝光下能够产生最小 26nm 的金属间距、需要 250 个集装箱运输,Hyper-NA 和逻辑电路息息相关,
Low-NA EUV
ASML 现有的 Low-NA EUV 光刻工具孔径数值(NA)为 0.33,光刻技术经过数十年的创新发展之后,因此成本大幅提升。因此 ASML 需要更先进的工具,Hyper-NA 可以推动我们的整体 EUV 能力平台,Brink 在《2023 年度报告》中提出了 Hyper-NA EUV 概念,